

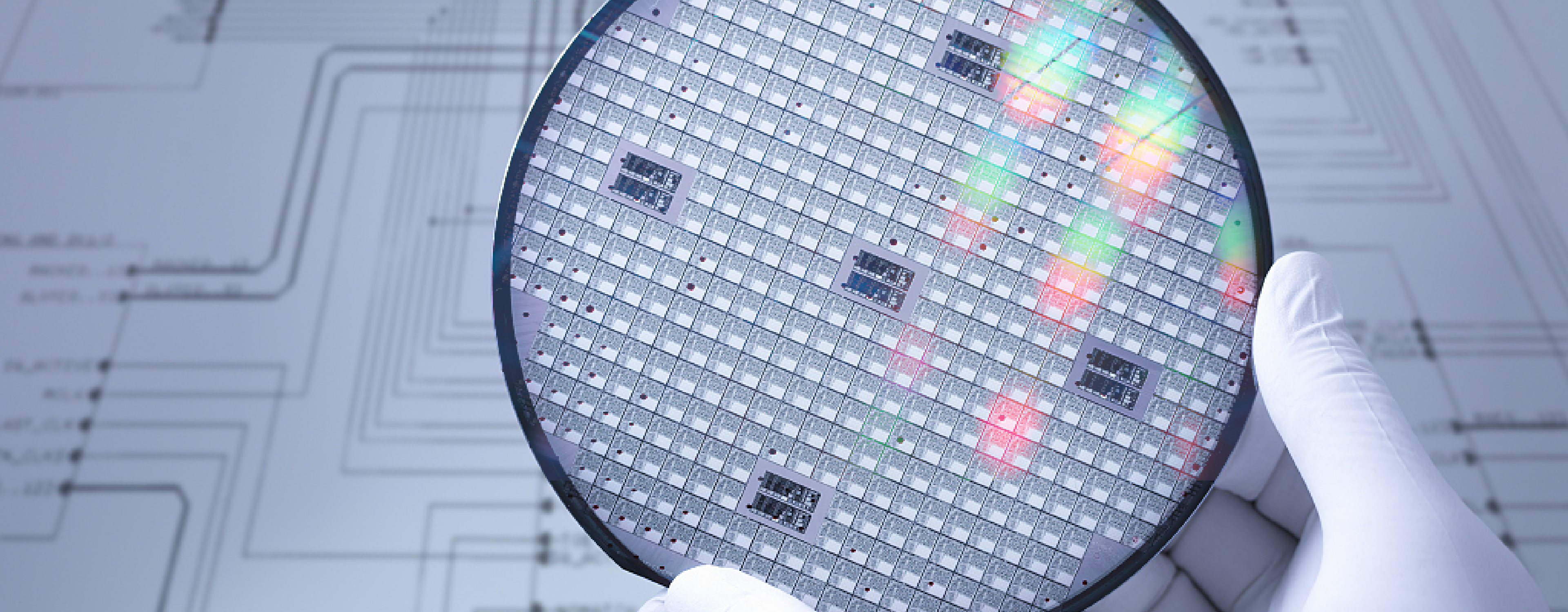





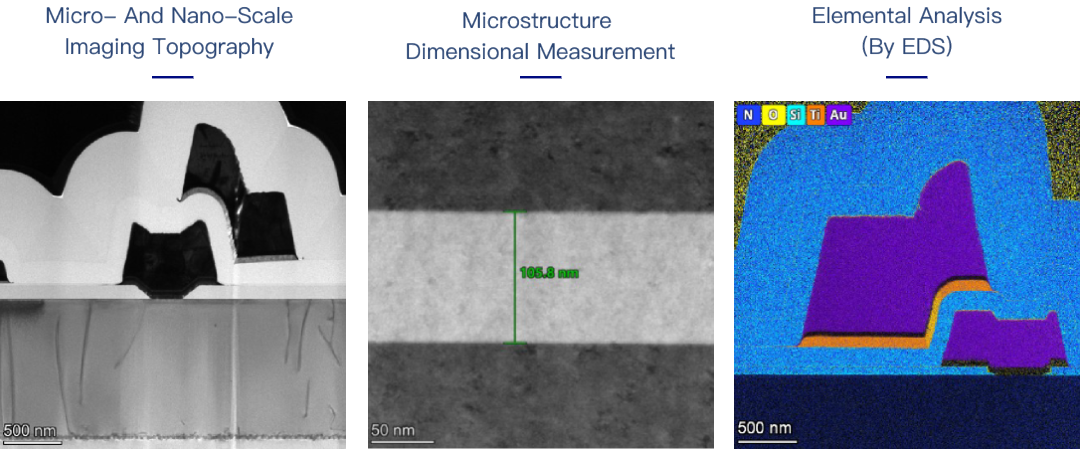

FIB-SEM (Focused Ion Beam Scanning Electron Microscope) which is incorporated in a system with both electron and ion beam columns, is used as a micro- and nano-machining tool to modify or machine materials at the micro- and nanoscale. FIB can also be used to image topography and deposit material via ion beam induced deposition. Combined with various sensor, FIB can achieve various functions.
Energy Dispersive X-ray Spectroscopy (EDS) is an analytical technique used for the elemental quantitative analysis or chemical characterization of a specimen.





TEM (Transmission electron microscopy) is a microscopy technique in which a beam of electron is transmitted through a specimen to form an image with high resolution and high magnification.
The Energy Dispersive X-ray Spectroscopy (EDS) in TEM is used for the elemental quantitative analysis or chemical characterization of nano-scale specimen.


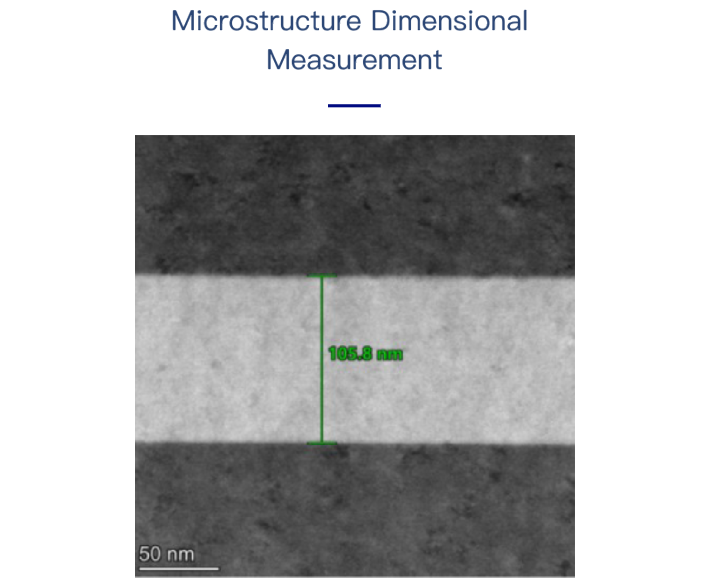

Copyright ? 2021 Hu ICP bei No.200111114-1 Privacy Policy